形態観察・元素分析
走査電子顕微鏡(SEM)、透過電子顕微鏡(TEM)、X線CT装置、走査型プローブ顕微鏡(SPM)を用いて、微細構造、結晶構造、表面状態などを明らかにします。

ナノ構造可視化(TEM)
透過電子顕微鏡(TEM)を用いて、ナノレベルの構造の可視化や結晶構造の解析を行います。
- 薄膜材料の多層構造の可視化
- 半導体チップの断面構造の可視化
- シリコン結晶欠陥の観察


微細構造可視化(SEM、FIB)
走査電子顕微鏡(SEM)や集束イオンビーム加工装置(FIB)を用いてサブミクロンサイズの微細構造や結晶状態などを可視化します。
- デバイス内部の異物解析
- EBSDによる多結晶薄膜の結晶方位、粒径解析
- イオンビームによるめっき膜結晶粒の観察
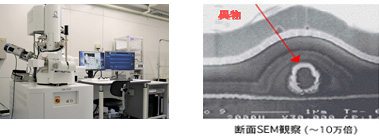

微小部の元素分析(WDX、EDX)
真空中で試料表面に電子線を照射し、構成元素を明らかにします。マッピング分析やB~Uまでの定量分析も可能です。
- 各種デバイスの異物および腐食原因分析
- 各種デバイス断面のマッピング分析
- 薄膜の定量分析


内部構造の非破壊可視化(X線CT)
X線CT装置を用いて、試料の内部構造を非破壊で可視化します。
- 電解コンデンサの非破壊可視化による不良解析
- 非破壊での基板配線パターン可視化による設計支援


微小領域の表面形状・物性評価(SPM)
走査型プローブ顕微鏡(SPM)を用いて、微小領域の表面凹凸や各種物性のマッピングを行い、試料の表面状態を明らかにします。
- めっき膜の表面粗さ測定
- デバイス内部の微小部の導電性評価
- 試料表面微小部の電位差測定


金属腐食トラブル解析
商品開発・品質向上に向けた金属腐食によるトラブルの原因を明らかにします。(→詳細)
- 金属腐食状態の分析
- 半導体表面の解析
- プリント基板のスルーホール内面の銅めっきの腐食
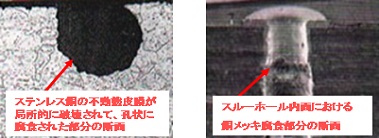

元素組成の分析
蛍光X線分析(XRF)、X線回折(XRD)により、固体試料(粉体、薄膜など)や液体試料 (水性、油性)の元素組成を明らかにします。
- 半導体デバイスの薄膜合金層などの元素組成分析(主成分、不純物)
- ポリマー中のフィラーや顔料の元素組成分析
- 機械油、切削油中の磨耗成分(元素組成)の特定

