TOF-SIMSによる表面分析
各種デバイスの製造には、成膜、エッチング、洗浄などの様々なプロセスがありますが、それらのプロセスにおける表面汚染や異物付着が引き起こす工程トラブルによって、目的の製造仕様を満たすことができない場合があります。このようなトラブル原因解明の手段の1つとして、TOF-SIMS分析があります。

TOF-SIMS分析の原理、特徴
飛行時間型 二次イオン質量分析(TOF-SIMS;Time of Flight Secondary Ion Mass Spectrometry)は、各種材料の極表面(~2nm )の元素、分子の定性分析を行う表面分析手法です。超高真空中で固体試料へ収束化したイオンビームを照射すると、スパッタリング現象に伴って、中性粒子と二次イオンが真空中へ放出されます。この二次イオンが検出器に到達するまでの飛行時間を精密に計測することで、試料表面の構成元素を調べることができます。また、TOF-SIMSは通常のSIMS とは異なり、試料へ照射する一次イオンの量が非常に少ないために、試料表面に付着している分子も検出することが可能です。ごく表面における有機物に関係する情報も取得できることが特徴的な表面分析手法です。
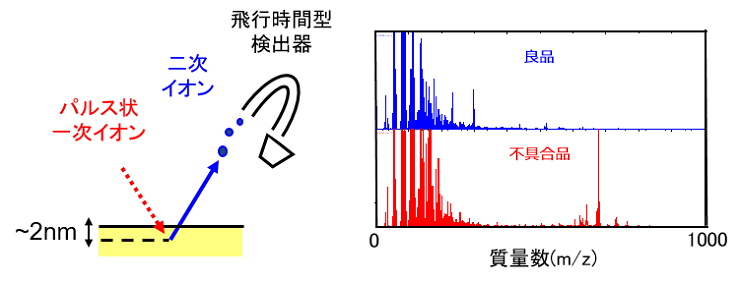

電極表面のTOF-SIMS分析
半導体プロセスの複雑化に伴い、ドライエッチング後の洗浄不足が原因となる品質不良が増えてきています。この事例では、金電極表面へのワイヤボンディング実装時のシェア強度が実装規格に到達していませんでした。
TOF-SIMS分析を用いて金電極表面の汚染物を定性分析したところ、アルキルベンゼンスルホン酸が検出されました(下図の赤)。アルキルベンゼンスルホン酸は、一般的な界面活性剤成分であり、電極洗浄剤に含まれている成分と推定することができます。実際に使用していた電極洗浄剤をウェハ上に塗布して測定を行ったところ、同じ分子量のアルキルベンゼンスルホン酸が検出されたため、この洗浄剤成分の残渣によってシェア強度が低下して、界面剥離に至ったと結論付けることができました。
新たな洗浄工程を追加することでシェア強度の実装規格を満たすことができたため、同様にTOF-SIMSによる評価を行ったところ、界面活性剤成分は消失しており、清浄な金電極に由来するピークを検出することができました(下図の青)。
TOF-SIMS分析による表面分析を行うと、品質不良の原因となる汚染物を特定することができ、最適なプロセス条件の導出に役立てることができます。


撥水性シリコン表面のTOF-SIMS分析
HMDS(ヘキサメチルジシラザン)処理は、半導体プロセスで使用されるレジスト塗布前の前処理です。この処理をシリコン表面に行うことで、ウェハ表面を疎水化し、レジストの密着性を高めることができます。
このような表面処理は基本的に数分子層レベルの表面処理であるため、実際に処理がされているかどうかを確認するには、極表面に敏感な分析手法を用いる必要があります。
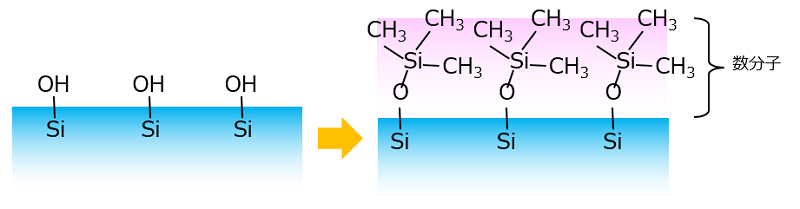
下の図は、実際にHMDS処理を実施した前後での接触角測定結果です。HMDS処理を行うことで、接触角が大きくなる結果が得られました。

このような最表面に差異がある試料に対して、検出深さの非常に浅い(~2nm)TOF-SIMS分析は非常に有効な分析手法です。同じ試料にTOF-SIMS分析を実施したところ、HMDS処理後の質量スペクトルでは、SiC3H9+ のピークに顕著な増加が認められました。撥水化の役割を果たすメチル基(CH3+)を含む分子イオンを高感度に検出できています。更にマッピング分析においても明瞭な差異を確認することができます。

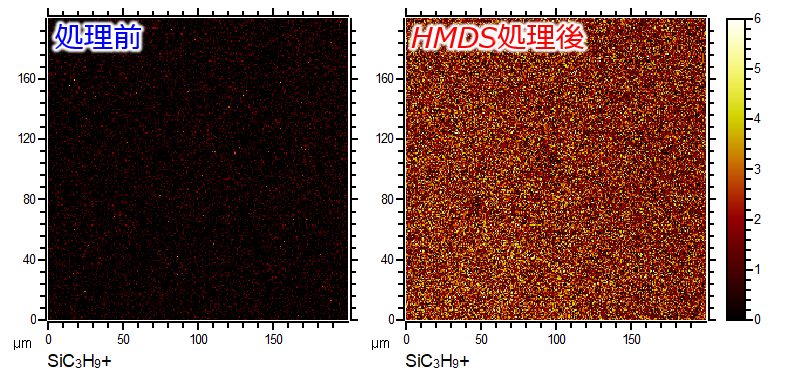
TOF-SIMSでは、試料表面の撥水性成分や親水性成分を高感度に検出することが可能です。同時に接触角測定を実施することで、付着している成分の定性分析と実際の濡れ性を関連付けて評価することができます。

集光レンズ表面のTOF-SIMS分析
近年のレーザーデバイスの高出力化に伴い、レーザーの集光レンズ、ビームスプリッタに求められる品質も要求水準が高くなっております。中でも鉄鋼材料のレーザー溶接に使用される半導体レーザーは、非常に出力の高いものが多く、内部の光学経路に損傷を与えるケースも少なくありません。

下の図は集光レンズ表面をTOF-SIMSで分析した結果になりますが、レンズ表面に成膜されていた反射防止膜(フッ化マグネシウム)がレーザーにより消失していることが明らかになりました。また、レンズ表面からシリコンが検出されており、レーザー照射による発熱によりデバイス周辺環境からの有機シリコーンが分解し、付着したことが示唆されました。レーザーの最終的な出力低下には様々な要因が考えられますが、TOF-SIMSを用いて表面分析を行うことで、これらの要因を切り分けることが可能です。